Микроскоп ближнепольный WITec alpha 300
| Номер в ГРСИ РФ: | 48289-11 |
|---|---|
| Категория: | Микроскопы |
| Производитель / заявитель: | Фирма "WITec GmbH", Германия |

Для измерений геометрических параметров рельефа поверхности в лабораториях научно-исследовательских институтов, оптическом приборостроении.
Информация по Госреестру
| Основные данные | |||||||
|---|---|---|---|---|---|---|---|
| Номер по Госреестру | 48289-11 | ||||||
| Наименование | Микроскоп ближнепольный | ||||||
| Модель | WITec alpha 300 | ||||||
| Характер производства | Единичное | ||||||
| Идентификатор записи ФИФ ОЕИ | 62b89bc5-47f0-e0f4-4c98-a51e434a584a | ||||||
| Испытания |
|
||||||
| Год регистрации | 2011 | ||||||
| Общие данные | |
|---|---|
| Технические условия на выпуск | тех.документация фирмы |
| Класс СИ | 27.01 |
| Год регистрации | 2011 |
| Страна-производитель | Германия |
| Центр сертификации СИ | |
| Наименование центра | ГЦИ СИ ВНИИМС |
| Адрес центра | 119361, г.Москва, Озерная ул., 46 |
| Руководитель центра | Кононогов Сергей Алексеевич |
| Телефон | (8*095) 437-55-77 |
| Факс | 437-56-66 |
| Информация о сертификате | |
| Срок действия сертификата | . . |
| Номер сертификата | 44508 |
| Тип сертификата (C - серия/E - партия) | Е |
| Дата протокола | Приказ 6335 от 25.11.11 п.23 |
Производитель / Заявитель
Фирма "WITec GmbH", ГЕРМАНИЯ
Германия
Цинглерштрассе 70 89077 Ульм Тел. +49 731 - 3788 0070, Факс +49 731 - 3788 0079, E-mail: info@russland-experten.com
Поверка
| Методика поверки / информация о поверке | МП 48289-11 |
| Межповерочный интервал / Периодичность поверки |
2 года
|
| Зарегистрировано поверок | |
| Актуальность информации | 04.01.2026 |
Поверители


Скачать
|
48289-11: Описание типа
2011-48289-11.pdf
|
Скачать | 97.5 КБ | |
| Свидетельство об утверждении типа СИ | Открыть | ... |
Описание типа
Назначение
Микроскоп ближнепольный WITec alpha 300 (далее микроскоп) предназначен для измерений геометрических параметров рельефа поверхности в лабораториях научноисследовательских институтов, оптическом приборостроении.
Описание
Принцип работы микроскопа ближнепольного WITec alpha 300 заключается в сканировании поверхности образца источником оптического излучения с размерами, много меньшими длины волны света, который находится на малом расстоянии от поверхности (в ближнем поле излучения). Это позволяет преодолевать дифракционный предел, т.к. в данном случае разрешение уже не зависит от длины волны.
Луч лазера через согласующий элемент попадает в полый кантилевер, на острие которого находится отверстие, служащее диафрагмой и имеющее размеры менее длины волны света. Взаимное перемещение острия и образца в трех измерениях x, y, z осуществляется с помощью пьезодвижителей. Прошедшие через образец или отраженные и рассеянные фотоны улавливаются одним из микрообъективов и направляются в фотоумножитель. В микроскопе ближнепольном WITec alpha 300 имеются вспомогательные узлы, позволяющие осуществлять также функции сканирующего туннельного или атомно-силового микроскопов. Благодаря этому, запись изображения осуществляется одновременно по двум каналам, один из которых воспроизводит рельеф поверхности, а другой - локальное распределение показателя преломления в тончайшем приповерхностном слое. Возможность различения оптического и топографического контрастов существенно упрощает интерпретацию изображения.

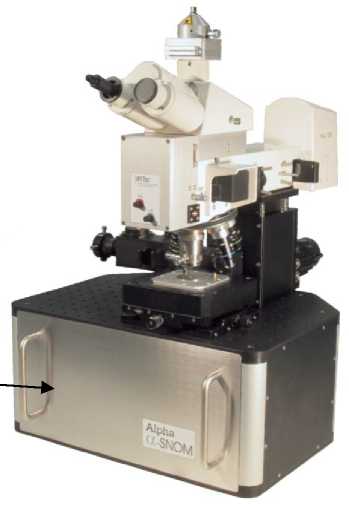
Рисунок 1 - Общий вид микроскопа ближнепольного WITec alpha 300
Программное обеспечение
Микроскоп оснащен программным обеспечением WITec Control версии v1.
Весь исходный код и вычислительный алгоритм WITec Control расположены в заранее скомпилированных бинарных файлах и не могут быть модифицированы. WITec Control задает пользовательские уровни. Пользователи административного уровня блокируют редактирование для пользователей низших уровней и не позволяют удалять, создавать новые элементы или редактировать отчеты.
Идентификационные данные программного обеспечения приведены в таблице
|
Наименование программного обеспечения |
Идентификационное наименование программного обеспечения |
Номер версии (идентификационный номер) программного обеспечения |
Цифровой идентификатор программного обеспечения (контрольная сумма исполняемого кода) |
Алгоритм вычисления цифрового идентификатора программного обеспечения |
|
WITec Control |
WITec Control.exe |
V1 |
08ACE575F265BC6 FBAFD50E100AE60 70 |
MD5 |
Программное обеспечение является неизменным. Средства для программирования или изменения метрологически значимых функций отсутствуют.
Защита программного обеспечения микроскопа соответствует уровню «С» по МИ 3286-2010.
Технические характеристики
|
Наименование параметра |
Значение параметра |
|
Линейное поле зрения в плоскости XY, мкм |
75х75 |
|
Диапазон измерений линейных размеров по оси Z, мкм |
свыше 0 до 6 |
|
СКО случайной составляющей погрешности измерений линейных размеров по осям X и Y, мкм |
±0,06 |
|
СКО случайной составляющей погрешности измерений линейных размеров по оси Z, мкм |
±0,035 |
|
Питание, В |
240 ±5 |
|
Температура окружающего воздуха, оС |
21 ±3 |
|
Относительная влажность воздуха (без конденсации), %, не более |
65 |
Знак утверждения типа
Знак утверждения типа наносится на титульный лист Руководства по эксплуатации и на корпус прибора методом наклеивания.
Комплектность
|
Наименование |
Кол-во |
|
Микроскоп ближнепольный WITec alpha 300 |
1 шт. |
|
ПЗС камеры |
3 шт |
|
Лазеры возбуждающего излучения (возбуждающие лазеры) |
2 шт |
|
Руководство по эксплуатации |
1 экз. |
|
Методика поверки |
1 экз. |
Поверка
осуществляется в соответствии с документом по поверке МП 48289-11 «Микроскоп ближнепольный WITec alpha 300. Методика поверки», разработанным и утвержденным ГЦИ СИ ФГУП «ВНИИМС» в сентябре 2011 г. и включенным в комплект поставки.
Основное поверочное оборудование: мера периода и высоты линейная TGQ1 (ГР №41680-09, период шаговой структуры: 3000±10 нм, высота профиля меры: 20±2 нм), мера периода и высоты линейная TGZ1, TGZ2, TGZ3 (ГР №41678-09, высоты выступов в шаговых структурах TGZ1 - 20±2 нм, TGZ2 - 110±10 нм, TGZ3 - 520±20 нм).
Сведения о методах измерений
Методы измерений изложены в документе «Микроскоп ближнепольный WITec alpha 300. Руководство по эксплуатации»
Нормативные документы
ГОСТ 8.296-78. ГСИ. Государственная поверочная схема для средств измерений параметров шероховатости Rmax, Rz и Ra в диапазоне 0,025.. .3000 мкм.
Рекомендации к применению
Выполнение работ по оценке соответствия промышленной продукции и продукции других видов, а также иных объектов установленным законодательством Российской Федерации обязательным требованиям.